- 收藏
- 加入书签
光纤法珀MEMS高灵敏压力传感器
摘要:针对高灵敏大量程的压力测量需求,基于硅的高反射率的光学特性,研制了一种光纤法珀式玻璃-硅结构的高灵敏压力传感器。采用MEMS湿法刻蚀加工方法制备了硅压力敏感薄膜。利用玻璃-硅阳极键合技术,实现了玻璃-硅的真空键合并形成了真空密闭的压力腔。搭建了压力测试系统,对研制的玻璃-硅传感器系统进行了性能测试。结果表面,高传感器能够实现0~3MPa范围下的压力测量;压力灵敏度为达到了876nm/MPa,分辨率达到了1.49037×10-4MPa,并具有较高的线性度,R2=0.999。
关键词:压力传感器;玻璃-硅,法珀干涉,MEMS,阳极键合
中图分类号:TP212
0 引言
高温压力传感器近年来在航空发动机健康监测领域有很大的应用需求,在航空发动机工作过程中,压气机、燃烧室、涡轮叶片等关键部件对压力和振动等参数有高精度的测量需要[1]–[3]。而电学类的压力传感器在不抗电磁干扰,容易出现欧姆接触失效,压阻系数退化等现象,难以应对这种复杂的高温压力环境,所以研究一种可在高温环境中可靠且稳定工作的压力传感器具有极其重要的工程应用价值。
与电学式压力传感器相比,光纤压力传感器因其耐高温、灵敏度高、抗电磁干扰、耐腐蚀,结构简单,体积小等优点而受到广泛关注。目前,大多数报道的光纤压力传感器用于静态压力测量和各种类型的光纤法布里-珀罗(法珀)压力传感器已制作使用MEMS,化学腐蚀,电弧放电,激光加工技术[4],[5]。其中,采用化学腐蚀、电弧放电和激光加工技术制造的压力传感器通常是单件生产,造成传感器之间的一致性较差。相比之下,MEMS技术可以应用于大规模生产,通过MEMS技术用于制造光纤压力传感器的材料主要包括硅、高硼硅玻璃、蓝宝石等。由于材料本身耐温性的限制,硅玻璃键合制作的压力传感器将需要考虑两种材料的耐温性。如果采用不同的材料制作光纤传感器或采用胶粘剂实现传感头与光纤的连接,不同材料之间的热膨胀系数的不匹配将很容易降低传感器的稳定性,导致在高温环境中产生较大的温度交叉敏感性。2022年中国石油化工集团公司胜利油田分公司杨斌[6]提出了用石英管制作法珀类压力传感器,压力测量范围为0.1~42 MPa,压力灵敏度为203.8nm/MPa。2023年中北大学安国文[7]提出了由保偏光子晶体光纤制作的法珀类压力传感器,可测量的压力范围为0~2.4MPa,最大灵敏度为54.491nm/MPa。虽然这些利用光纤制作的法珀类传感器可以测量范围广、耐受温度高,但是光纤容易弯曲,光纤内制作的法珀结构容易受到外部环境的干扰导致信号丢失。而MEMS制作的法珀类压力传感器具有良好的稳定性,容易封装,这将会大大延长传感器的使用寿命,对压力传感器的工程化有重大意义。
本文针对航空航天领域对于高精度压力测量需求,采用光学法珀式结构作为压力敏感结构,利用MEMS刻蚀技术和阳极键合技术结合制作了高强度密封的玻璃-硅压力敏感芯片,并搭建了相应的高精度光纤法珀压力测量系统。
1.传感器的结构设计及其工作原理
图1展示的是硅-玻璃键合压力传感器结构示意图,它是由压力敏感膜片,真空压力腔,玻璃基底和斜头单模光纤组成。压力敏感腔和压力敏感膜片都是由硅片经过MEMS湿法刻蚀形成的结构。压力敏感膜片的下表面与玻璃基底的上表面形成了真空法珀腔结构,当光从斜头光纤出射到传感器的法珀结构时,它将在3个界面发生反射,一次记为1,2,3,如图1中所示,三束反射光的一部分会被光纤接收并发生干涉,而且斜头光纤的端面不与传感器的法珀结构垂直,不产生多余干涉结构,这种斜头光纤作为光信号的收发装置可以避免平头光纤与传感器之间产生的潜在压力串扰腔的问题,也为光纤与传感器芯片的机械对准减小了难度。
压力传感器结构受到外部的气体压力激励时,压力腔的压力与外部压力之间会产生一个新的平衡,即敏感膜片向内凹陷变形,导致法珀腔长改变。外部压力越大,敏感膜片的向内凹陷的程度越高,法珀腔尺寸就越短。其压力腔与外部气压大小之间的关系为:
其中,p为作用在压力敏感膜的压力值;E为弹性模量;ν 为泊松比;a、h 分别为传感膜片的有效半径和厚度。由公式(1)可以看出,外部压力的大小只与压力腔的大小成正比关系,其他参量都为材料本身的固有特性,与芯片结构和芯片材料性质没关系。
在不考虑半波损失、界面的光损耗和空气介质损耗的前提下,当在光纤内传输的光经过斜头光纤端面出射,经过压力传感器后反射回到光纤内部后,其光纤接收到的光强信号为:
其中E为光纤接收到的反射光总电场;E(i)为入射光的电场分量 n12、n23分别为1.5μm波段左右的范围的玻璃和硅材料在真空环境的折射率,R1、R2、R3分别为界面1、2、3 的反射率,反射率R =(n1-n2)/(n1+n2),d23为真空法珀腔的长度,d12为SiC基板的厚度,λ为入射光束的波长,4πnd为界面间的相位差;其中d为法珀腔的腔长尺寸。
图2展示的是玻璃-硅结构的MEMS芯片的在中心波长为1542nm,带宽为30nm的宽带光源下通过光谱采样得到的三光束干涉产生的光谱数据。采用的玻璃基底厚度为300μm,压力腔长120μm,压力敏感膜片厚度为90μm。从图中可以看出,每个峰的轮廓都非常均匀,没有双法珀调制的特征,这是因为在软件中已经通过低通滤波将玻璃基底的干涉谱过滤,其三光束干涉特征很难体现在该光谱中。
2.高灵敏光纤法珀式玻璃-硅压力MEMS芯片的制备
MEMS是微机电系统(Micro Electro Mechanical Systems)的缩写,是利用微细加工技术,可以将机械零零件、电子电路、传感器、执行机构集成在一块电路板上的高附加值元件。可以实现器件的微型化、集成化和批量生产。所以将MEMS工艺与压力芯片制作相结合可以制作出集成度高,表面粗糙度低,芯片厚度均匀,机械性能一致的小型MEMS压力芯片,有利于光学传感器系统的工程化应用。本文设计的基于MEMS玻璃-硅压力芯片是由玻璃基底和带有压力敏感结构的硅材料组成,这种芯片的制作工艺主要包括单晶硅的湿法刻蚀、玻璃和硅的阳极真空键合两个部分。
本文中采用是硅的各向异性刻蚀,硅片的处理主要分成以下三个步骤:清洗除尘、表面图形化、湿法刻蚀。刻蚀液是KOH、H2O、(CH3)2CHOH的混合液,其化学反应发生公式为:
通过改变刻蚀温度,各个化学试剂的溶液浓度配比来调整化学反应的速率,从而控制压力敏感薄膜的厚度与表面粗糙度。利用这种各项异性的湿法刻蚀方式将硅片的正面和反面都刻蚀出深度和表面粗糙度一样的结构,本实验中刻蚀的硅片厚度为330μm,硅片压力敏感尺寸大小为2×2mm,正反面的刻蚀深度都是120μm,压力敏感膜片厚度为90μm。
阳极键合,又称为电场辅助扩散连接[8]。这种键合是通过分子之间的共价键作用将不同材料表面粘合到一起,提高了压力腔的密封性,保护芯片内部免受损坏,污染,湿气和氧化或其他不良化学反应[9]。将刻蚀好的硅片和厚度为300μm的玻璃进行阳极键合,形成玻璃-硅压力敏感芯片。首先将玻璃和硅分别置于丙酮和酒精中超声清洗5min清洁,除去材料表面的油污并干燥。将玻璃与硅中心轴对称重叠放置在阳极键合炉中,首先高温和电场的作用下玻璃中的Na2O会产生电离的现象,电离产生的Na+离子在电场力的作用下发生定向迁移并脱离玻璃表面,在玻璃-硅的键合表面形成Na+离子耗尽层,强大的负电场会吸引硅片表面会聚集等量的正电荷,从而导致在键合表面的电场力作用下,玻璃和硅产生更加紧密的接触,其中的阴阳离子会互相迁移,在键合表面形成新的化学键,在600℃下利用大电场和负重载荷的双重作用下,将玻璃-硅键合到一起。
3. 高灵敏光纤法珀式玻璃-硅压力MEMS传感器性能测试
图3展示的是传感器系统的实验装置图,压力测试实验装置包括,中心波长1550nm中心波长和40nm带宽的光源,单模光纤环形器,传感器,压力计和氮气瓶;其中传感器是带有金属封装结构的玻璃-硅压力敏感芯片,光纤与芯片的连接方式如图1所示。压力计为传感器输出压力范围0~3MPa,精度为1KPa。氮气瓶为压力测量提供压力源。
3.1 压力测试
整个压力测试是在环境温度为25℃,相对湿度为40%RH的恒温恒湿环境中进行。图4展示的是在压力范围为0~3MPa,步进为0.5MPa的压力下,传感器与压力计显示的压力值大小。图中黑色曲线展示的是压力敏片中的法珀腔长随着传感器承受的压力增大而减小的关系曲线,从图中可以看出,法珀腔长与压力值之间呈线性变化关系,压力灵敏度为876nm/MPa,这说明传感器的压力敏感膜片制作良好,表面机械应力均匀,结构设计合理,适用于0~3MPa的压力测量。图中红色曲线展示的是压力计输出值与传感器解调的压力值之间的关系,从这个数据中可以看出,压力计显示的数值与传感器解调的压力值基本保持一致,线性度达到了0.999,该拟合直线的斜率接近1但不为1的原因是传感器系统本身有一定的背景噪声导致解调的压力值稍有差别。
3.2 传感器系统稳定性测试
图4中展示的是标准压力值与压力测量值之间还是稍有误差,这表明传感器系统中还存在一定的噪声,该系统在一段时间内保持其压力敏感性的优劣也是压力测量的关键因素。图5展示的是传感器系统在环境温度为25℃,相对湿度为40%RH的恒温恒湿环境,不加载外部压力激励情况下的腔长监测情况,整个传感器系统监测33min,在每分钟记录一个压力腔的数值,从图中可以看出,压力腔的波动范围为120.519~120.5205μm,变化0.0015μm。根据监测的数据可知其系统标准差为4.024×10-4μm,即传感器系统可以分辨1.49037×10-4MPa的压力波动。
4 结论
本文提出了一种基于MEMS工艺和阳极键合工艺结合的光纤法珀式玻璃-硅高灵敏压力传感器。该传感器采用的是阳极键合的真空法珀腔的玻璃-硅传感器芯体结构。利用硅MEMS湿法刻蚀技技术,加工出了低粗糙度、高反射率、双面刻蚀深度均为120μm,膜片厚度为90μm的硅片结构。通过真空阳极键合技术,实现了压力腔的高强度真空密封可靠键合,实现了压力腔的保护。测量结果表明,传感器能够实现在常温下的0~3MPa范围内的高灵敏压力测量,压力灵敏度为达到了876nm/MPa,分辨率达到了1.49037×10-4MPa。这种传感器不单单可以在常温状态下进行压力测量,有希望在超过200℃的高温环境下实现温度和压力复合参量的测量,在高灵敏的压力测量领域奠定了良好的工程化背景。
参考文献:
[1]盛天宇,李健,李鸿昌,等. 光纤法珀式SiC耐高温压力传感器的制造与测试[J]. 中国机械工程,2022,33(15):1803–1809.
SHENG Tianyu,LI Jian,LI Hongchang,et al. Fabrication and Measurement of SiC Fiber-optic Fabry-Perot Pressure Sensors for High-temperature Applications[J]. China Mechanical Engineering,2022,33(15):1803-1809.
[2]孙博山,熊继军,李晨.耐高温压力—振动复合传感器设计与仿真[J].传感器与微系统,2022,41(09):16-19,24.
SUN Boshan,XIONG Jijun,LI Chen. Design and simulation of high temperature pressure-vibration composite sensor[J].Sensors and Microsystems,2022,41(09):16-19,24.
[3]江俊峰,刘铁根,刘琨,等. 基于激光加工硅片的光纤法珀压力传感器研究[C]//中国光学学会.中国光学学会2010年光学大会论文集.[出版者不详],2010:4007-4012.
JIANG Junfeng,LIU Tiegen,LIU Kun,et al. Research on optical fiber Faper pressure sensor based on laser processing silicon wafer[C]//Chinese Optical Society. Proceedings of the 2010 Optical Conference of the Optical Society of China. [Publisher unknown],2010:4007-4012.
[4]Wang W,Wu N,Tian Y,et al.Miniature all-silica optical fiber pressure sensor with an ultrathin uniform diaphragm[J].Optics Express,2010,18(9):9006-14.
[5]Y. Zhang,L. Yuan,X. Lan,et al. High-temperature fiber-optic Fabry–Perot interferometric pressure sensor fabricated by femtosecond laser[J].Optics Letters,2013,38(22):4609.
[6]杨斌,赵庆超,车传睿,等. 《高精度光纤温度压力传感器及其在生产井的应用》,激光与光电子学进展,期 17 vo 59,页 128–133,2022:.
YANG Bin,ZHAO Qingchao,CHE Chuanrui,et al. "High-precision fiber optic temperature and pressure sensor and its application in production wells",Advances in Laser and Optoelectronics,Issue 17 vo 59,pp. 128–133,2022:.
[7]安国文,王立志,牛慧青,等.基于微结构光纤和游标效应的高灵敏度压力传感器[J].光学技术,2023,49(03):305-310.
AN Guowen,WANG Lizhi,NIU Huiqing,et al. Highly sensitive pressure sensor based on microstructured optical fiber and vernier effect[J].Optical Technology,2023,49(03):305-310.)
[8]齐虹,丁文波,张松,等.圆片级叠层键合技术在SOI高温压力传感器中的应用[J].传感器与微系统,2019,38(02):154-156,160.
QI Hong,DING Wenbo,ZHANG Song,et al. Application of wafer-level laminated bonding technology in SOI high temperature pressure sensor[J].Sensors and Microsystems,2019,38(02):154-156,160.)
[9]谷专元,何春华,何燕华,等. MEMS硅玻璃阳极键合工艺评价方法[J].传感器与微系统,2017,36(10):54-56.
GU Zhuanyuan,HE Chunhua,HE Yanhua,et al. Evaluation method of anodic bonding process of MEMS silicon glass[J].Sensors and Microsystems,2017,36(10):54-56.
作者简介:刘亚娟(1974-),女,工程师,主要从事高温环境下的压力传感器研究工作。




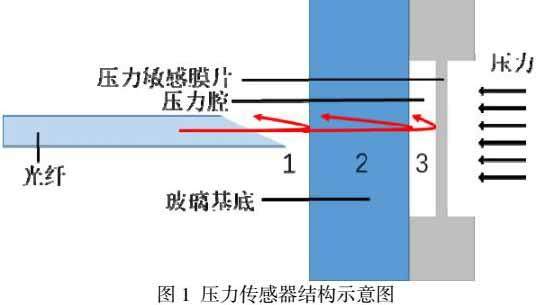
 < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-3-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-3-l.jpg"> < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-4-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-4-l.jpg"> < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-5-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-5-l.jpg"> < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-6-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-6-l.jpg"> < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-7-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-7-l.jpg">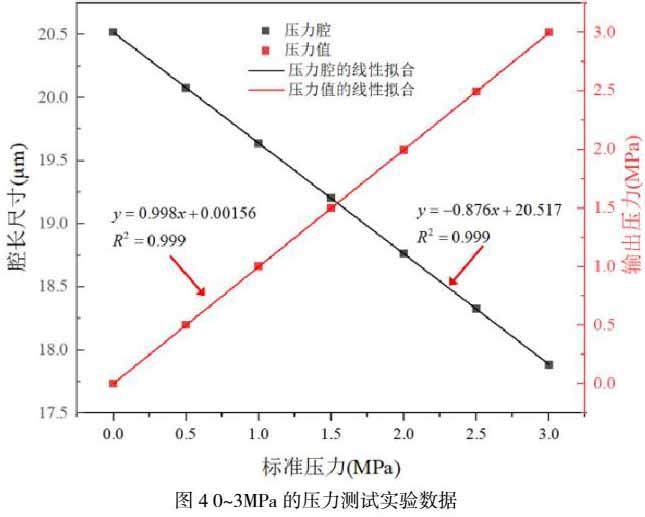 < a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-8-l.jpg">
< a rel="example_group" title="Custom title" href="http://img.resource.qikan.cn/qkimages/a38d/a38d202314/a38d202314868-8-l.jpg">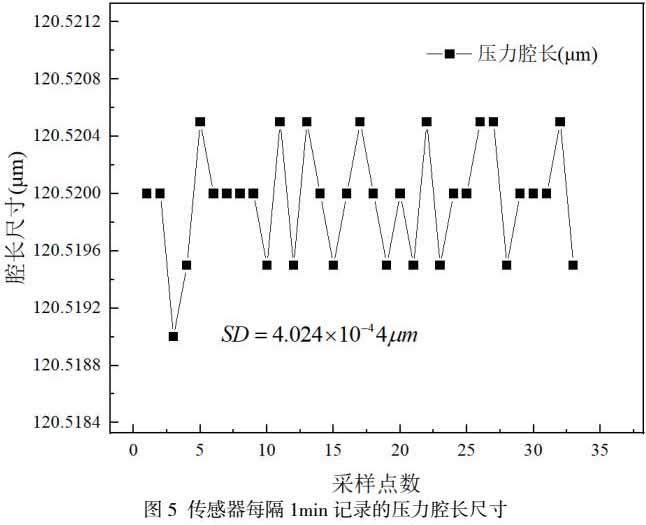

 京公网安备 11011302003690号
京公网安备 11011302003690号

