
- 收藏
- 加入书签
碳化硅化学机械抛光增效技术与作用机理研究进展
摘要:作为第三代半导体材料,碳化硅(SiC)晶圆的表面要求具有超光滑、无缺陷和无亚表面损伤的特性。然而,由于 SiC 的硬脆性和化学稳定性,使得对其表面进行超精密加工变得极其困难。化学机械抛光(CMP)作为 SiC 晶圆平坦化的关键技术,传统的 CMP 技术存在抛光效率低和表面质量不理想等问题。因此,需要采用各种增效技术来提高 CMP 的效率和质量。本文对现有的 CMP 增效技术进行了分类总结,主要从优化化学反应和优化机械磨削两个角度进行讨论。通过调整 CMP 液体中的化学成分和浓度,以及改变磨料的形状、硬度和尺寸等参数,可以改善 CMP的抛光效果。此外,利用电化学反应、超声波和振动等辅助技术也可以提高 CMP 的效率和质量。通过进一步优化 CMP 工艺,提高 SiC 晶圆的加工效率和表面质量,将推动SiC CMP 技术的发展。
关键词:碳化硅;化学机械抛光;辅助增效;去除机理
0 引言
碳化硅(SiC)作为宽禁带第三代半导体材料[1,2],是 5G 通信电源、新能源汽车充电桩、轨道交通电力电子装置、大数据中心和工业互联网服务器电源、特高压输电功率器件等重要领域的核心材料,尤其是在航天、国防等领域有着不可替代的作用。目前我国在新兴产业的技术水平、产业化规模等方面都处于国际优势地位,这将促进我国上游半导体行业的持续发展,进一步提高我国半导体企业在国际市场的影响力,尤其对碳化硅器件将产生巨大的需求。
作为衬底材料,SiC 晶圆的表面质量和加工精度直接影响着电子器件的性能,产品要求晶圆表面超光滑、无缺陷、无亚表面损伤,表面粗糙度达到纳米级以下,但是 SiC 的硬脆性大, 化学 其表面的超精密加工难度极大、加工成本高,严重限制 SiC 的应用和发展。因此,如何提高抛光表面质量和加工效率成为碳化硅制造应用和发展方面急需解决的关键技术问题[5,6]。而将化学机械抛光(ChemicalMechanical Polishing,CMP)通过各种手段进行增效是解决上述关键问题的重要途径之一
本文综述了多种 SiC 化学机械抛光增效技术工艺以及机理的研究现状,并对其发展方向进行了展望。
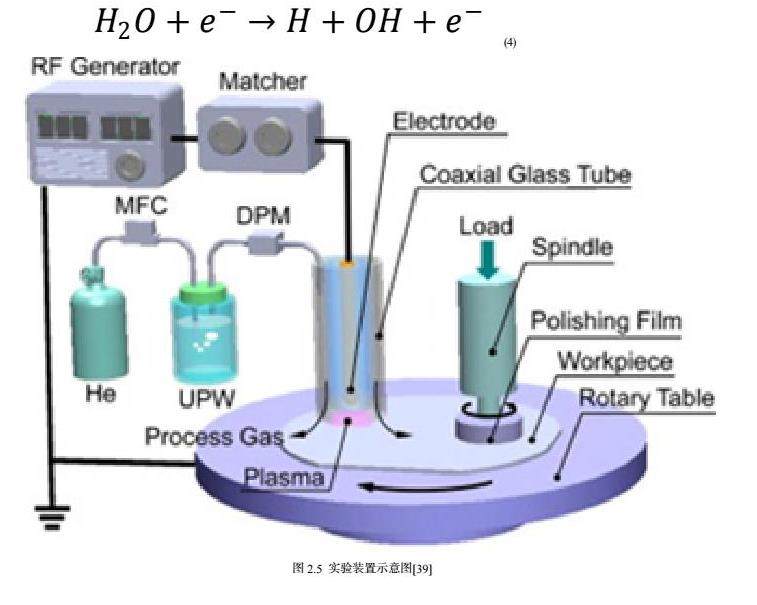
1 碳化硅 CMP 技术原理
CMP 加工处理技术是目前实现 SiC 晶圆表面平坦化最广泛最有效的方法[7]。主要是通过抛光液的化学反应和机械去除交替作用来去除表面材料,以便获得具有高质量表面的工件,如图 1- 1 为 CMP 加 示意图。研究证实传统的 CMP 可以获得较高质量的表面,但是材料去除率很低。为保证碳化硅表面加工质量,提高 CMP 的加工效率,降低加工成本,科研人员从提高抛光液化学反应速率和去除率,以及优化抛光加工工艺增强化学作用等方面研发多种增效技术。
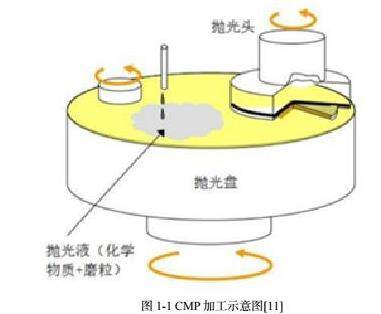
2 改进化学氧化方法提高碳化硅 CMP 效率
2.1 Fenton 反应辅助化学机械抛光
Fenton 反应是最强的氧化反应之一,它是利用过氧化氢(H2O2)和二价铁离子(Fe2+)之间的反应生成氧化性极强的羟基自由基(?OH),能有效地对有机污染物进行降解[13]。以 Fe2+作为催化剂为例,形成的芬顿反应如下:



2017 年,广东工业大学的徐少平[12]等研究了产生 Fenton 反应 Fe、FeO、Fe2O3、Fe3O4 等 4 种铁系固相催化剂的效果。结果发现当 Fe3O4作为催化剂时,SiC 表面能够产生明显的化学反应,生成较软易去除的 SiO2 氧化层,化学机械抛光时材料去除率最高达到 到 17.2 mg/、表面粗糙度最低达到 Ra2.5 nm。2018 年,Lu[15]等研究了芬顿反应中的?OH 浓度对抛光效果的影响,并得到了粗糙度为 0.1869 nm 的 SiC 光滑表面。利用 UV 光催化芬顿反应,在抛光液中加入 TiO2,提高碳化硅氧化层的形成速度。他们还将磁流变抛光与芬顿反应相结合提出化学磁流变复合抛光(CMRF)[16]。研究发现,磨料和羰基铁粉含量越高,CMRF 的材料去除能力越强,机械效应对材料去除的贡献大于化学效应。磨料机械效应对材料去除率的贡献达到 63.41%-91.42%,抛光垫和化学效应对材料去除率的贡献分别为 4.81-10.37%和 3.74-26.22%。2.2 碳化硅表面预处理辅助化学机械抛光化学反应由于其不易控制,很容易造成过度腐蚀,为了使化学反应速率可控,利用超快激光器来辅助 SiC CMP,超快激光加工 -精度高、损伤和缺陷少、应用范围广等优点,特别适用于透明 料和熔融 石英等硬脆 料和碳化硅[20]。激光将会在 SiC 表面上形成了厚度约 10\~50 nm的连续非晶层以及细波纹和粗波纹的周期性分布,这将会大大提高抛光液与 SiC 晶片表面的直接接触面积,从而有效提高材料去除率,如图2.2 为激光诱导原理示意图及其处理后表面形貌。
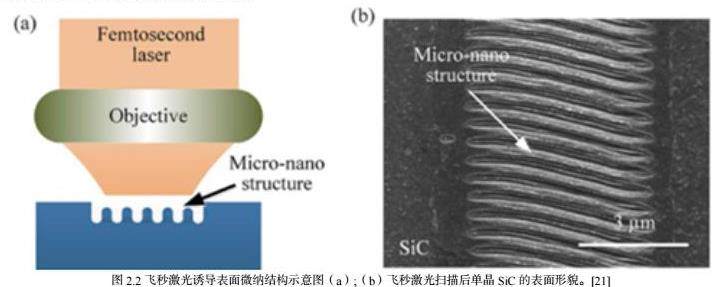
2021 年,清华大学的 Chen[22][23]等提出高密度激光使材料产生等离子体,等离子体在等离子体膨胀过程中会与大气分子剧烈碰撞,使空气中的气体分子电离产生自由基。SiC 在自由基的作用下与大气中的氧气反应生成氧化物。
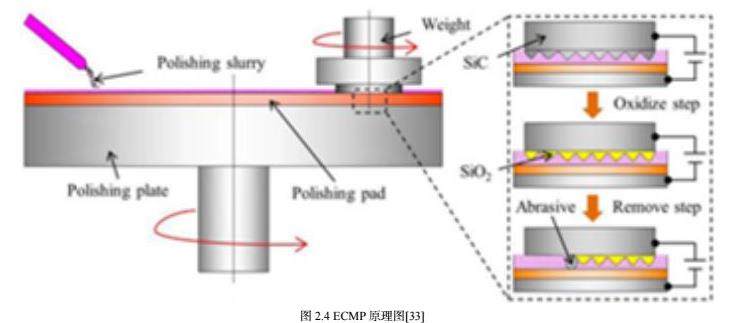
2.3 光催化辅助化学机械抛光(PCMP
近几年,光催化辅助化学机械抛光(PCMP)吸引了更多研究者的注意。其辅助原理是利用紫外光催化反应产生的?OH 和 SiC 发生化学反应,在 SiC 材料表面氧化生成硬度较低 SiO2 反应层,SiO2 层在机械抛光过程中更容易通过磨料去除。如图 2.3 为 PCMP 原理示意图。
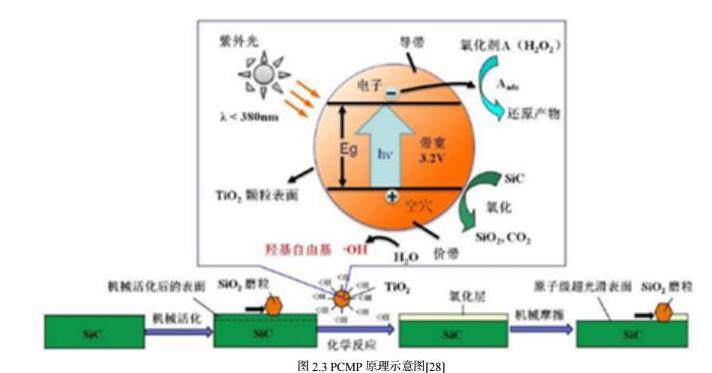
2003 年,日本熊本大学的 Ishikaw[29]等发现室温下 TiO2 作为光催化剂可产生强氧化性的?OH,促使 SiC 分解为 CO2 和 SiO2,TiO2 光催化处理可得到无亚表层损伤的纳米级表面。随着对光催化技术的广泛应用,其较低的氧化效率已经为瓶颈,于是越来越多的研究致力于该技术的氧化效率。
2019 年,路家斌等[30][31]人通过紫外光催化辅助对 6H-SiC 进行化学机械抛光,研究表明抛光材料去除率呈现光照抛光液>光照抛光盘>无光照的规律。清华大学的 Li 等[32]在传统胶体 SiO2 抛光液中添加经紫外线修饰的碳纳米管-TiO2 复合催化剂颗粒,在室温下对 SiC 进行抛光,通过试验得到 Ra 为 0.043 nm 的原子级光滑表面,材料去除率为 0.126 μm/h。
2.4 电场辅助化学机械抛光(ECMP)
ECMP 是将电化学反应和机械抛光两者进行相互作用协调的加工方式 ,在 SiC 晶片表面的阳极氧化速度可以通过调节氧化电流的大小和电化学抛光期间的通电时间来改变反应速率,然后机械去除速度可以通过改变工艺参数来进行控制。ECMP 原理示意图如图 2.4。
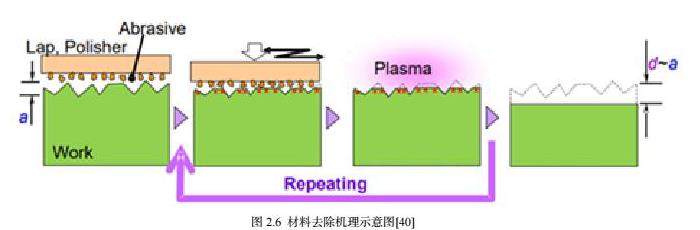
2004 年,美国雷恩塞勒理工学院的 C.H.Li 等[34]发现该方法在低氧化电流密度下,抛光材料的去除率很低,表面质量较好。增加了氧化电流,尽管晶片表面上的氧化物层的厚度增加,但是抛光后的表面粗糙度 Ra 也增加。Luo[35]等尝试在不同材质的抛光盘上进行电化学腐蚀其中铝盘效果最好。
2018 年.大阪大学的徐洋[36]等对4H-SiC(0001)表面的初始阳极氧化阶段进行 AFM 观察。结果表明,氧化从表面阶地边缘开始,然后扩展到阶地底部。在氧化过程的后半部分产生了大的氧化物突起,并且氧化导致这些氧化物突起在产生后膨胀。
2.5 等离子体辅助化学机械抛光(PAP)
由于等离子体的强改性,PAP 结合了等离子体辐照的表 和软磨料的抛光 ,使用含有高浓度羟基自由基(?OH)的水蒸气等离子体进行表面改性[37]。当 SiC 基板表面被水蒸气等离子 被水蒸气等离子体产生的?OH 氧化。经证实,主要氧化产物为 SiO2,并且发现 SiO2 和碳化硅之间存 图 2.5、图 2.6 所示。尽管在等离子体中产生?OH有几种可能的反应,但在水蒸气等离子体中最有可能的反应被认为是由电子撞击引起的水解离产生自由羟基,其反应方程式为:


2021 年,西安理工大学的 Ma[41]等提出了一种结合等离子电解处理和机械抛光(PEP-MP)的新型抛光技术。等离子体电解处理后,单晶 4H-SiC 表面的硬度从 2891.03HV 大大降低到 72.61 HV,抛光后得到超光滑表面,表面粗糙度从 Sz607 nm、Ra64.5 nm 降低到 Sz60.1 nm、Ra8.1 nm,PEP-MP 的材料去除率(MRR)约为 21.8 μm/h。
2021 年,南方科技大学的 Ji[42]等结合软磨粒抛光技术实现 SiC 材料高效去除的等离子体辅助抛光技术,经过抛光实验,得到了粗糙度为 0.11 nm 的表面。
2023 年,大连理工大学的刘继宇[43]等,讨论了低温等离子体辅助加工的机理和应用。在介绍了低温等离子体的特性、分类和作用机理之后,描述了低温等离子体对各种难切削材料不同加工工艺的影响。
3 优化机械去除方法提高碳化硅 CMP 效率
对抛光液中的磨粒进行改性与复合经常被用于 CMP 的增效[44]。改性复合磨粒通过在 SiC 化学机械抛光过程中引入特定成分,能够提高磨料与碳化硅表面的相互作用,从而增强抛光效果。这些化学成分可以改善磨料的磨削性能,加速材料的去除过程,并优化表面质量,从而实现 SiC 表面平坦化。
3.1 利用改性复合磨粒提高 SiC 抛光效果
2004 年,美国国家能源技术实验室的 Heydemann 等[45]应用含 SiO2 和 0.1 μm 金刚石混合颗粒的抛光液抛光 6H-SiC,得到 Ra 为 0.55nm 的表面,材料去除率为 0.6 μm/h。Lee 等[46]采用混合纳米 SiO2(120 nm)和金刚石(50 nm ,25 g/L)的抛光液对 6H-SiC 进行 CMP,获得了Ra 为 0.27 nm 的表面。增大金刚石颗粒浓度(35 g/L)可提高材料去除率到 0.55 μm/h(Ra 为 0.37 nm)。而氧化剂被引入抛光液中,可进一步提高碳化硅的 CMP 材料去除率。
2022 年,郑州大学的王一博[47]等人以水和乙醇的混合液作为分散体系,用均相沉淀法制备了金刚石/CeO2 复合颗粒,5-10 nm 的 CeO2颗粒均匀分布在金刚石表面形成颗粒沉积型核壳结构。
固结磨料抛光的主要原理是将磨料固定于抛光液上,同时使用不包含磨料的抛光液在抛光设备上进行抛光的一种方法。由于磨粒在抛光垫表面分布均匀,且沟槽有利于排出抛光液和废屑,能有效防止抛光垫表面出现釉化现象。因为其抛光原理基于二体磨损原理,对抛光液的依赖大大减弱,更容易去除工件表面凸起部分[48]。半固结磨料采用特殊结合剂来结合磨粒,使得磨粒在基体的一定范围内具有移动能力。半固结磨料研磨加工的表面质量要优于固结磨料,但材料去除率较低。半固结磨料在研磨过程中可以不添加水性研磨液,但其在加工以及长期储存过程中容易失效[49]。图 2.8 为固结磨料抛光示意图,图 2.9 为其表面微观形貌。
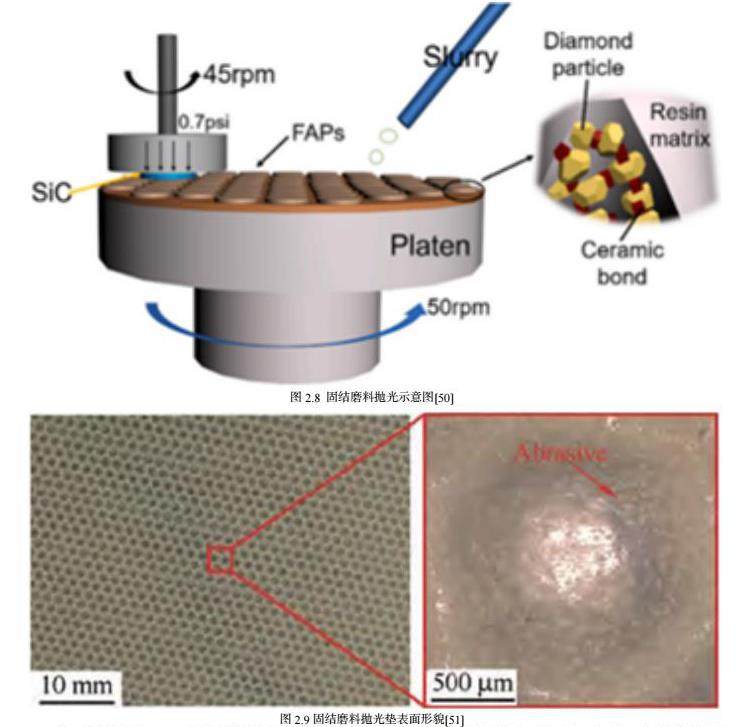
2016 年,华侨大学的 Luo[52]等将固结磨料与半固结磨料在其他条件相同的情况下将其抛光效果进行对比,发现使用半固结磨料抛光垫可以轻松获得具有纳米级粗糙度的光滑基材表面,抛光效果优于固结磨料抛光垫。2023 年,日本立命馆大学的 Murata[53]等使用由固体聚合物电解质和 CeO2 粒子组成的离子导电复合垫,将 ECMP 与半固结磨料相结合,达成了 14.8 μm/h 的高 MRR 以及 Sa 为 0.084 nm 的超光滑表面。
2021 年,国立勤益科技大学的 Tsai[54]等将金刚石等多种不同磨料混合到抛光垫上,制成一种新型的固结混合磨料抛光垫,混合抛光垫对 SiC 基体的材料去除率(MRR)高于传统方法。磨削磨损率可降低31.6%。
2022 年,南京航空航天大学的 Yao[55]等采用光固化法制备了自回归固结磨料抛光垫(SR-FAPP)。研究了 SR-FAPP 的物理力学性能和SR-FAPP 上磨料颗粒的退缩阈值。用聚氨酯抛光垫和 SR-FAPP 对 SiC 晶片进行 CMP 后,发现前者在抛光 SiC 晶片中的材料去除率比后者高 75%,后者在抛光 SiC 晶片时的表面粗糙度比前者高 75%。
USCMP 的作用方式主要为:超声波引起碳化硅颗粒和磨料之间的微小振动,从而增加了它们之间的相对运动速度。这样可以提高磨料对材料表面的撞击频率和能量,促进磨料与材料表面之间的有效碰撞,增加抛光效果。超声波产生的高频振动可以促进溶液中的气泡的生成和破裂,形成局部的液流和微小的涡旋。这些液流和涡旋可以帮助清除材料表面的颗粒、磨屑和残留物,提高抛光的均匀性和精度。超声波能够促进溶液中活性离子的传输和扩散,使得溶液中活性离子在材料表面发生局部剥蚀反应。这种剥蚀作用可以去除碳化硅材料表面的氧化物、污染物和粗糙层,提高表面质量[56]。
MRF 是利用磁流变流体在磁场的作用下产 变效应 ,从而形成具有高粘度和低流动性的 Bingham 体特性的柔性“小磨头”,工件和柔性的“小磨头”产生相对较高的剪切力,在快速相对运动过程中去除表面材料[59]。图 2.10 为磁流变加工原理图及其抛光设备。
3.3 超声振动辅助化学机械抛光(USCMP)
3.4 磁流变技术辅助化学机械抛光(MRF)
2019 年,广东工业大学的闫等[60][61]采用一种动态集群磁流变平面抛光法,对单晶 SiC 进行抛光,30min 可将晶片表面粗糙度由 70nm下降至 1.9nm。为进一步增强抛光效果,将磁流变和化学机械抛光组合使用。

行 35 min 快速均匀抛光,改善了 SiC 晶圆表面的缺陷,消除了晶圆亚表面损伤,有利于提升 SiC 晶圆的加工效率、精度及质量。
,长春理工大学的杨超[63]等,采用环抛技术将单晶 SiC 晶圆表面粗糙度快速加工至 0.6 nm 左右;采用磁流变抛
2020 年,广东工业大学的邓佳云[64]等制备了一种水基高催化活性磁流变化学精抛光液,并对其进行改性,以提高单晶 SiC 磁流变化学精抛光的化学作用强度。改性抛光液的催化活性提高了 65.4%;SiC 的MRR 提高了 72.5%,达到 635.621 nm/h,并获得粗糙度为 0.33 nm 的表面。
2023 年,康明[65]等研究了碳化硅陶瓷非共振振动辅助磁流变精加工(NVMRF)的材料去除机理,提出了考虑振动的抛光力理论模型以解释振动对抛光力的影响。
4 SiC 化学机械抛光多重增效原理研究及应用
CMP 性能的提高源于化学氧化和机械去除过程的协同作用。当机械去除弱于化学氧化时,4H-SiC 晶圆表面的氧化层不能及时去除。这阻碍了氧化并最终降低了 MRR。为此,研究人员为了平衡机械磨削与化学氧化作用之间的平衡,会采用多种不同的增效方式协同作用达到提高材料去除率的同时降低表面粗糙度的作用。
5 总结与展望
在化学方面,芬顿反应可以提高 SiC 的 CMP 加工速率。但 CMP 之后的残留铁离子对后续清洁工作提出了挑战,对于 PCMP,由紫外光激发产生光生电子和空穴很容易重新结合在一起,这也成为了目前阻碍 PCMP 抛光效率的一大因素,如何阻碍光生电子与空穴的再结合是后续研究的重点。
综上所述,我们对碳化硅的 CMP 技术的发展进行了总结,已经有大量学者在碳化硅晶圆加工中取得了巨大成功,提出了在化学、物理两个不同方面以及化学物理协同增效增强 SiC 的 CMP 效果。
目前 SiC 的 CMP 机理并不明朗,还存在很多问题亟待解决,例如在液体磨料与硅基片表面的相互作用和磨削力学方面,以及对亚表面损伤层的形成机理等,需要投入大量研究才能解决。随着碳化硅精密加工技术的不断发展,抛光也向着更大尺寸、更光滑的表面质量发展。参考文献
1 Chen X, Yang X, Xie X, et al. Research progress of large size SiC single crystal materials and devices[J]. Light: Science & Applications, 2023, 12(1): 28.
2. Cheng Z, Liang J, Kawamura K, et al. High thermal conductivity in wafer-scale cubic silicon carbide crystals[J]. Nature communications, 2022, 13(1): 7201
3. Huang Y, Zhou Y, Li J, et al. Understanding the role of surface mechanical properties in SiC surface machining[J]. Materials Science in Semiconductor Processing, 2023, 163: 107594.
4. Wang W, Lu X, Wu X, et al. Chemical-Mechanical Polishing of 4H Silicon Carbide Wafers[J]. Advanced Materials Interfaces, 2023: 2202369.
5. Tsai M Y, Wang S M, Tsai C C, et al. Investigation of increased removal rate during polishing of single-crystal silicon carbide[J]. International Journal of Advanced Manufacturing Technology, 2015,80(9-12):1511-1520.
6. Murata J, Hayama K, Takizawa M. Environment-friendly electrochemical mechanical polishing using solid polymer electrolyte/CeO2 composite pad for highly efficient finishing of 4H-SiC (0001) surface[J]. Applied Surface Science, 2023, 625: 157190.
7. Hsieh C H, Chang C Y, Hsiao Y K, et al. Recent advances in silicon carbide chemical mechanical polishing technologies[J] Micromachines, 2022, 13(10): 1752.
8. 李运鹤. 碳化硅晶圆化学机械抛光工艺优化实验研究[D].河南工业大学,2023. 9. Chen G M, Ni Z F, Bai Y W, et al. The role of interactions between abrasive particles and the substrate surface in chemical-mechanical planarization of Si-face 6H-SiC[J]. RSC ADVANCES, 2017,7(28):16938-16952.
10. Zhang Q X, Pan J S, Zhang X W, et al. Tribological behavior of 6H-SiC wafers in different chemical mechanical polishing slurries[J] WEAR, 2021,472.
11. 陈国美. 碳化硅晶片超精密抛光工艺及机理研究[D].江南大学,2018.
12. 徐少平,路家斌,阎秋生等.单晶 SiC 化学机械抛光液的固相催化剂研究[J].机械工程学报,2017,53(21):167-173.






 京公网安备 11011302003690号
京公网安备 11011302003690号


